[비즈니스포스트] 정부가 반도체 첨단 패키징 기술 경쟁력 강화를 위해 7년간 2700억 원 이상의 예산을 투입한다.
산업통상자원부는 11일 서울 서초구 엘타워에서 반도체 관련 기업과 기관 10곳이 ‘반도체 첨단 패키징 산업 생태계 강화를 위한 업무협약(MOU)’을 맺었다고 밝혔다.
![정부 반도체 패키징 강화에 2700억 투자, 삼성전자·SK하이닉스 포함 10곳 업무협약]()
이날 협약식에는 삼성전자, SK하이닉스, LG화학, 하나마이크론, 한미반도체, 세미바이브 등 종합 반도체 기업과 팹리스(반도체 설계) 기업, 소부장(소재·부품·장비) 기업 등이 참여했다.
또 PCB&반도체패키징산업협회, 차세대지능형반도체사업단, 한국반도체산업협회, 한국산업기술기획평가원 등 협회도 함께 했다.
반도체 패키징은 원형 웨이퍼 형태로 생산된 반도체를 자르고 전기 배선 등을 연결해 제품에 탑재할 수 있는 형태로 만드는 작업으로, 후공정(OSAT)이라고 불린다.
최근 초미세 공정 기술의 한계를 극복하기 위해 다양한 반도체를 묶어 성능 최적화를 돕는 중요 기술로 부각되며, 글로벌 반도체 기업들이 막대한 투자를 진행하고 있다.
산업부는 추진해온 ‘반도체 첨단 패키징 선도 기술개발 사업'이 지난 6월 정부의 예비타당성조사를 통과해 예산 확보에 성공하자 이날 MOU를 추진했다.
이번 사업에는 내년부터 2031년까지 총 2744억 원이 투자된다.
산업부에 따르면 이번 MOU를 통해 첨단 패키징 초격차 선도 기술 개발, 소부장 및 OSAT 기업의 핵심 기술 확보, 차세대 기술 선점을 위한 해외 반도체 전문 연구기관과의 협력 체계 구축 등을 추진한다.
또 인력양성 등 후공정 산업 미래를 위한 지원도 함께 추진한다. 김호현 기자
산업통상자원부는 11일 서울 서초구 엘타워에서 반도체 관련 기업과 기관 10곳이 ‘반도체 첨단 패키징 산업 생태계 강화를 위한 업무협약(MOU)’을 맺었다고 밝혔다.
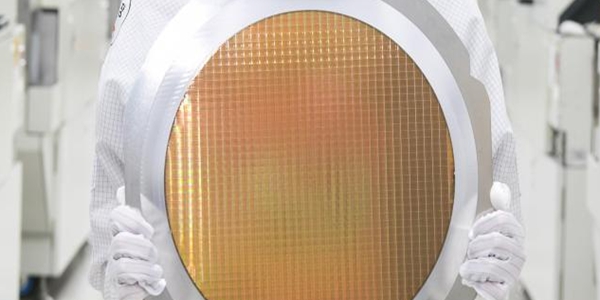
▲ 실리콘을 원료로 사용한 반도체 웨이퍼 위에 칩이 생산된 모습. < SK하이닉스 >
이날 협약식에는 삼성전자, SK하이닉스, LG화학, 하나마이크론, 한미반도체, 세미바이브 등 종합 반도체 기업과 팹리스(반도체 설계) 기업, 소부장(소재·부품·장비) 기업 등이 참여했다.
또 PCB&반도체패키징산업협회, 차세대지능형반도체사업단, 한국반도체산업협회, 한국산업기술기획평가원 등 협회도 함께 했다.
반도체 패키징은 원형 웨이퍼 형태로 생산된 반도체를 자르고 전기 배선 등을 연결해 제품에 탑재할 수 있는 형태로 만드는 작업으로, 후공정(OSAT)이라고 불린다.
최근 초미세 공정 기술의 한계를 극복하기 위해 다양한 반도체를 묶어 성능 최적화를 돕는 중요 기술로 부각되며, 글로벌 반도체 기업들이 막대한 투자를 진행하고 있다.
산업부는 추진해온 ‘반도체 첨단 패키징 선도 기술개발 사업'이 지난 6월 정부의 예비타당성조사를 통과해 예산 확보에 성공하자 이날 MOU를 추진했다.
이번 사업에는 내년부터 2031년까지 총 2744억 원이 투자된다.
산업부에 따르면 이번 MOU를 통해 첨단 패키징 초격차 선도 기술 개발, 소부장 및 OSAT 기업의 핵심 기술 확보, 차세대 기술 선점을 위한 해외 반도체 전문 연구기관과의 협력 체계 구축 등을 추진한다.
또 인력양성 등 후공정 산업 미래를 위한 지원도 함께 추진한다. 김호현 기자











